近年、科学技術の急速な発展に伴い、照明・ディスプレイ分野におけるLED技術の応用はますます拡大しています。LED技術の中核部品であるLEDチップの製造プロセスと性能特性は、大きな注目を集めています。
LEDチップ製造の主な目標は、効果的で信頼性の高い低抵抗接触電極を作成し、接触材料間の電圧降下を小さくし、適切なワイヤボンディングパッドを提供しながら、光出力効率を最大化することです。コーティングプロセスでは、主に真空蒸着法が用いられます。4Paの高真空環境で、抵抗加熱または電子ビーム照射加熱により材料を溶融します。その後、低圧下で材料は金属蒸気となり、半導体材料の表面に堆積します。通常、P型接触金属にはAuBe、AuZnなどの合金が使用され、N型接触金属にはAuGeNi合金がよく使用されます。コーティングによって形成された合金層は、フォトリソグラフィープロセスを経て、発光領域を可能な限り露出させる必要があります。これにより、残りの合金層は低抵抗接触電極およびワイヤボンディングパッドの要件を満たすことができます。フォトリソグラフィープロセスが完了したら、合金化プロセスが必要です。これは通常、H2またはN2の保護下で行われます。合金化時間と温度は、半導体材料の特性や合金化炉の形状などの要因に応じて決定されます。青緑などのチップ電極プロセスを伴う場合は、パッシベーション膜の成長やプラズマエッチングなどのより複雑なプロセスを追加する必要があります。
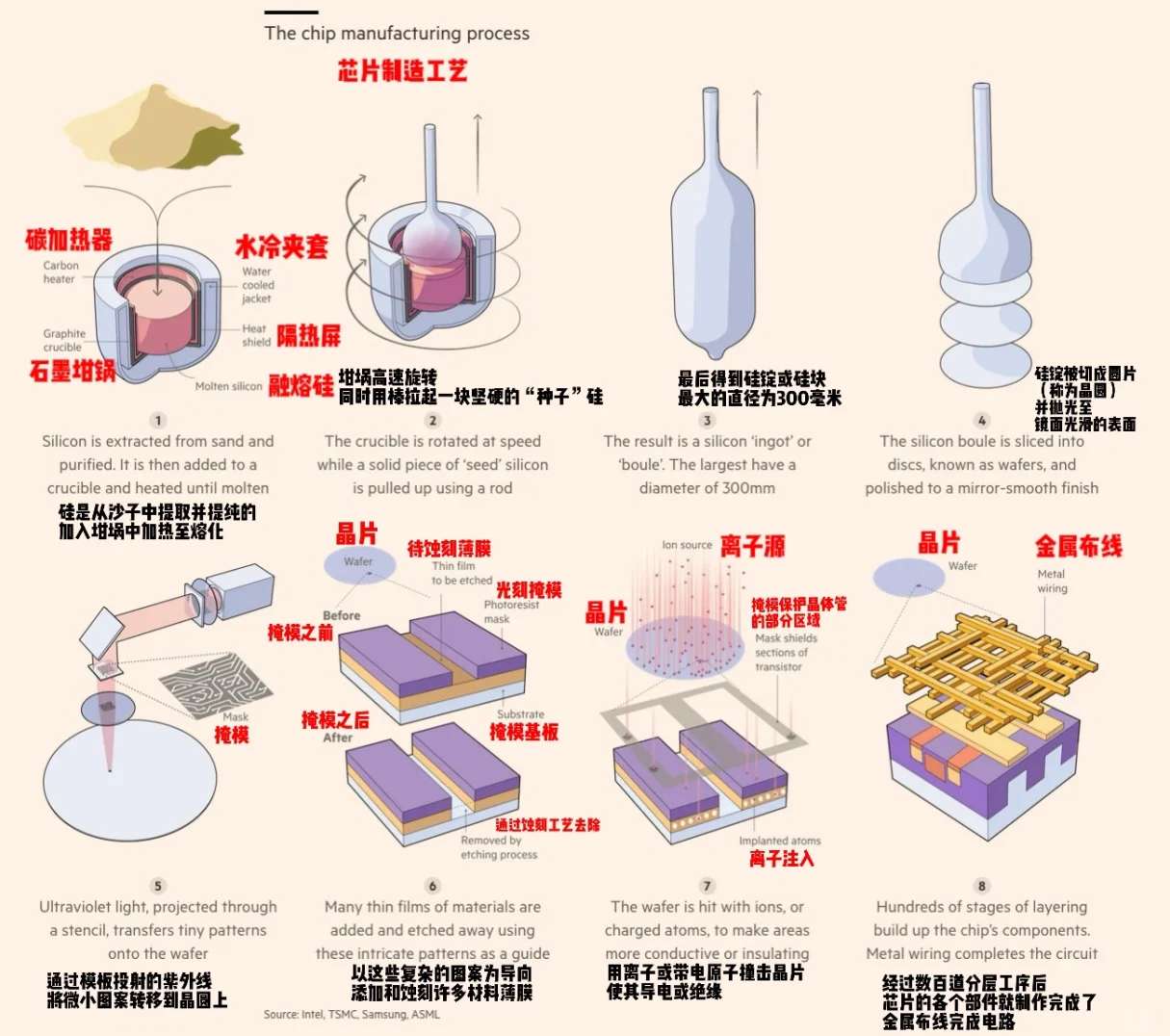
LEDチップの製造プロセスにおいて、複数の工程が光電子性能に大きな影響を与えます。一般的に、LEDのエピタキシャル生産が完了すると、主要な電気特性はほぼ確定します。チップ製造はチップの本質を変えることはありませんが、コーティングおよび合金化プロセス中の不適切な条件は、いくつかの電気的パラメータの劣化につながります。例えば、合金化温度が高すぎたり低すぎたりすると、オーミック接触が不良になり、チップ製造における順方向電圧降下VFが高くなる主な原因となります。切断後、チップエッジを腐食させることで、チップの逆リーク電流を低減します。これは、ダイヤモンド砥石の刃を切断した後、チップエッジに大量のデブリ粉末が残るためです。これらのデブリがLEDチップのPN接合に付着すると、リーク電流や故障の原因になりやすくなります。さらに、チップ表面のフォトレジストがきれいに剥離されていないと、前面のワイヤ溶接や冷間圧接が困難になり、背面で大きな電圧降下が発生するなどの問題が発生します。チップ製造工程では、表面を粗くし、逆台形構造に分割することで光強度を効果的に向上させることができます。
LEDチップは、電力に応じて低出力、中出力、高出力の3種類に分けられ、顧客のニーズに応じて単管、デジタル、ドットマトリックス、装飾照明などに分類できます。チップの具体的なサイズは、チップメーカーの実際の生産レベルによって異なり、統一された標準はありません。プロセスが標準を満たしている限り、チップを小さくすることで単位出力を増やし、コストを削減でき、光電子性能は根本的に変わりません。チップの動作電流は、チップを流れる電流密度と関係があります。チップが小さいほど動作電流は小さく、チップが大きいほど動作電流は大きくなりますが、単位電流密度は基本的に同じです。高電流下では放熱が重要な問題となるため、高出力チップの発光効率は低電流チップよりも低くなります。一方、チップ面積の増加とボディ抵抗の減少により、順方向導通電圧は低下します。

市場で一般的に使用されている白色光用高出力LEDチップの面積は、一般的に約4000万平方メートルです。いわゆる高出力チップとは、通常1W以上の電力を指します。量子効率は一般的に20%未満であるため、電気エネルギーの大部分が熱エネルギーに変換されます。そのため、高出力チップの放熱性は極めて重要であり、チップ面積を大きくする必要があります。
GaNエピタキシャル材料の製造チッププロセスと処理装置は、ギャップ、ガリウムヒ素、InGaAlPとは大きく異なります。通常のLED赤色・黄色チップや高輝度4元素赤色・黄色チップの基板には、GaPやGaAsなどの化合物半導体材料が使用されています。これらは通常、N型基板にすることができ、フォトリソグラフィー技術を用いてウェットプロセスで処理し、最後にダイヤモンドホイールブレードでチップに切断します。GaN材料の青緑色チップはサファイア基板を使用しています。サファイアは絶縁体であるため、LEDの一方の極として使用することはできません。ドライエッチングプロセスにより、エピタキシャル表面に2つのP / N電極を同時に作る必要があり、パッシベーションプロセスもいくつか必要です。サファイアは硬いため、ダイヤモンドホイールブレードでチップに切断することが難しく、GaPやGaAs材料のLEDよりもプロセスが複雑です。
透明電極チップは独特の構造と特性を持っています。いわゆる透明電極は、導電性と光透過性の2つの特性を備えている必要があります。現在、液晶製造プロセスではインジウムスズ酸化物(伊藤)が広く使用されていますが、はんだパッドとして使用することはできません。製造する際には、まずチップの表面にオーミック電極を作り、次にITOの層で覆い、最後にITOの表面にはんだパッドをめっきする必要があります。このようにして、リードから降りてくる電流は、ITO層を介して各オーミック接触電極に均等に分配されます。同時に、ITOの屈折率は空気とエピタキシャル材料の屈折率の間であるため、光出力角度が広がり、光束が増加します。
半導体LED技術の発展に伴い、照明、特に白色LEDへの応用が注目されていますが、肝心のチップとパッケージング技術は依然として改善が必要です。チップに関しては、今後は高出力、高光効率、そして低熱抵抗化へと向かうでしょう。出力の増加は、チップの使用電流の増加を意味します。最も直接的な方法はチップサイズを大きくすることです。現在一般的な高出力チップのサイズは約1mm×1mmで、使用電流は約350mAです。使用電流の増加に伴い、放熱の問題はより顕著になっています。現在、チップフリップ方式によってこの問題は基本的に解決されています。
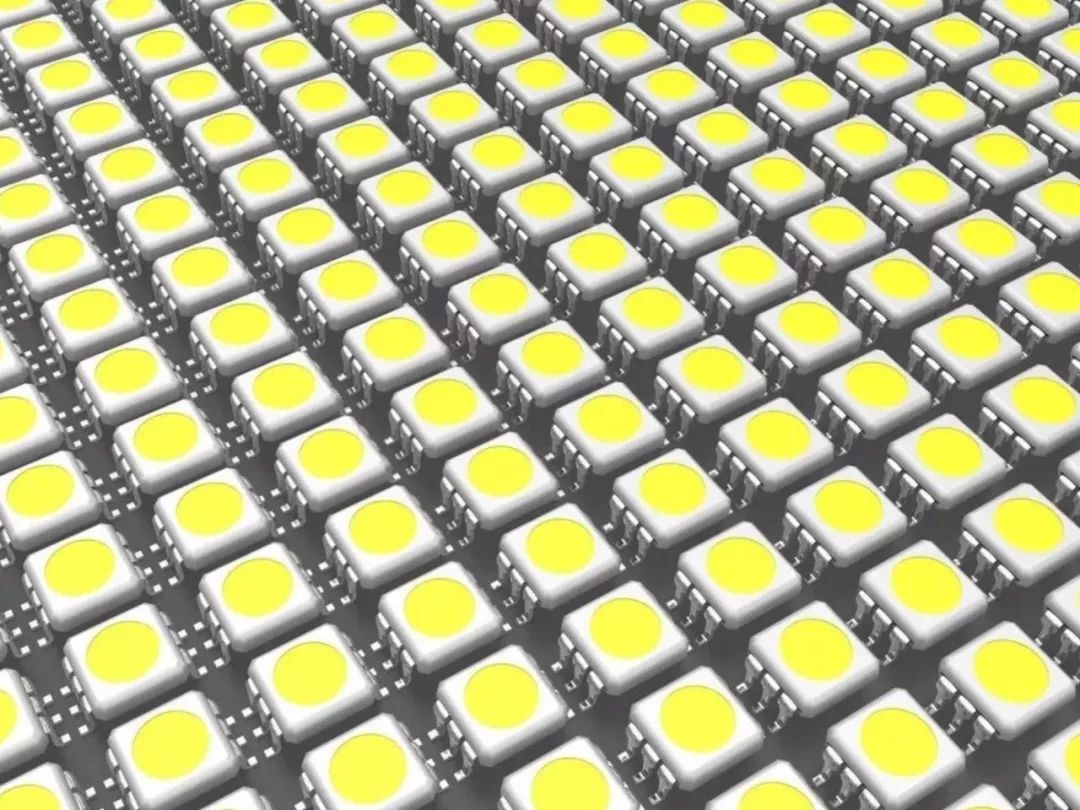
青色LEDは、硬度が高く、熱伝導性と電気伝導性が低いAl2O3基板をよく使用します。正構造にすると、静電気対策の問題だけでなく、大電流条件下では放熱も大きな問題になります。また、前面電極が上を向いているため、光の一部が遮られ、発光効率が低下します。高出力青色LEDは、従来のパッケージング技術に比べて、チップフリップチップ技術によってより効果的な光出力を得ることができます。主流のフリップチップ構造の製造プロセスは、まず共晶溶接に適した電極を備えた大型の青色LEDチップを準備し、同時に青色LEDチップより少し大きいシリコン基板を準備し、その上に共晶溶接用の金導電層とリード線層(超音波金線ボールはんだ接合)を作ります。次に、共晶溶接装置を使用して、高出力青色LEDチップをシリコン基板に溶接します。この構造では、エピタキシャル層がシリコン基板に直接接触しており、シリコン基板の熱抵抗はサファイア基板よりもはるかに低いため、放熱の問題を効果的に解決します。反転後、サファイア基板が上向きになり、発光面になります。その透明性により、発光の問題も解決されます。
業界の専門家は、科学技術の継続的な進歩により、LEDチップ技術は革新を続け、将来のLEDランプは高効率と長寿命において大きな進歩を遂げ、人々の生活にさらなる利便性をもたらすと期待していると述べた。

